HF-Packaging, Signal- und Powerintegrität
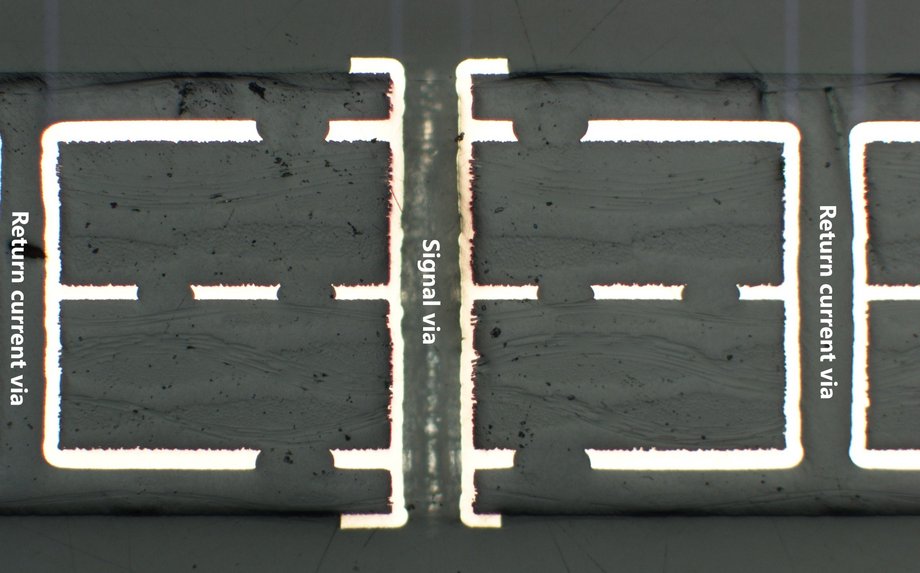
Der Schwerpunkt unserer Forschung liegt auf den folgenden Bereichen:
1) Untersuchung der grundlegenden Ursachen von Problemen der Signalintegrität (SI), der Powerintegrität (PI) und der elektromagnetischen Verträglichkeit (EMV) in HF-Packages und -Leiterplatten, Wellenleitern und HF-Front-End-Modulen mit integrierten Antennen bis zu Terahertz-Frequenzen
2) Methoden zur HF-Charakterisierung von Strukturen der Aufbau- und Verbindungstechnik, die Segmente der Signalpfade (Engl. signal distribution network, SDN) und des Stromverteilungsnetzes (Engl. power distribution network, PDN) bilden. Dies umfasst:
- Chip-zu-Package-Interconnects, z. B. Bonddrähte, Flip-Chip-Verbindungen
- Spannungsversorgungslagen (Engl. Power-Ground Planes) mit/ohne Entkopplungskondensatoren
- Leitungen, z.B. in Umverdrahtungslagen (RDLs)
- 3D Interconnects, z. B. Through Silicon Vias (TSVs), Through Glass Vias (TGVs), Through Hole Vias (THVs)
3) Methoden zur elektromagnetischen Modellierung, Charakterisierung und Minimierung von:
- Induktivität und Impedanz von PDNs
- Geometrische Diskontinuitäten (GD), Reflektionen und Übersprechen in SDNs
- Kopplung von Rauschen durch simultane Schaltvorgänge (Engl. simultaneous switching noise, SSN) und elektromagnetischer Interferenz (EMI), verursacht durch Rückstrompfad-Diskontinuität (Engl. return current path discontinuity, RPD) von Durchkontaktierungen in mehrlagigen Substraten
- Auswirkungen nicht idealer Effekte von Aufbau- und Verbindungstechnologien (z. B. Oberflächenrauhigkeit, dielektrische Effekte) auf SI, PI und EMV
- SI-, PI- und EMV-Probleme in HF-Packages/Interposern (mit High-Speed- und High-Bandwidth-Interconnects) für die heterogene 2D-, 2,5D- und 3D-Systemintegration von Chiplets, aktiven und passiven Komponenten
- Unerwünschte elektromagnetische Strahlung von Aufbau- und Verbindungstechnologien
